電動小型ダイレクトダイヤフラムバルブ:ECV®

2005年 第2回
モノづくり部品大賞「奨励賞」受賞製品
日刊工業新聞社様主催の「第2回'05モノづくり部品大賞」に於いて、フジキンの『電動小型ダイレクトダイヤフラム:ECV®』が、奨励賞を受賞。平成17年3月29日、表彰を賜りました。
また、併せて同製品は、東大阪商工会議所様より、優れた新製品や新技術を開発し、成長著しい企業に与えられる「東大阪モノづくり大賞」の最優秀賞:金賞の受賞を賜りました。ここに慎んでご報告申し上げますとともに、本製品に関し、東北大学未来科学技術共同研究センター未来情報産業創生部門教授 大見忠弘先生より過分なる推薦文を賜りましたので、次にご紹介申し上げます。これも偏に大見先生をはじめ皆々様の温かいご支援によるもので、満腔の謝意を申し上げます。
「第2回モノづくり部品大賞」
電動小型ダイレクトダイヤフラムバルブ:ECV®
推薦文
東北大学未来科学技術共同研究センター
未来情報産業創生部門
教授 大見 忠弘
まったくゆらぎの無い完全な再現性を有する半導体生産技術の創出を目指して、私は①完全クリーンなプロセス雰囲気, ②完全に制御され汚染の無い基板表面, ③結果に影響を与えるすべてのプロセスパラメータを完全に制御した半導体プロセス, を3原則とするウルトラクリーンテクノロジーを提唱してきました。すべての半導体プロセスのゆらぎの原因を究明し、その原因を除去するために超高純度ガス供給系,超純水供給系,超高純度薬液供給系,超高性能製造装置等の超高性能半導体生産ライン創出に必要な新たな素材・材料, 部品, 加工技術, 表面処理技術, 組立て施工技術, モニタ・制御技術を多くの企業と開発してきました。この中で私は、各種ガスの組成・濃度を精密に制御して装置に供給するガス供給系に不可欠な電動小型ダイレクトダイヤフラムバルブ(ECV®)を精密ながれ制御機器企業である(株)フジキンと共同で開発致しました。
少品種大量生産を得意としてきた半導体集積回路は、超多品種の少量・可変量生産を本質的に要求するデジタルネットワーク対応情報家電ビジネスが主戦場になろうとしています。60枚/hr程度のシリコンウェーハの生産能力を持つ製造装置は、一台で40,000枚/月程度の処理能力を発揮します。現状の半導体製造装置は一種類のプロセスしか行えない単機能装置です。こうした製造装置で半導体生産ラインを構成すると、すべての装置をフル稼働にするためには、最低でもシリコンウェーハ25,000枚/月の処理が必要となり、初期投資額が200mmウェーハで一千億円, 300mmウェーハでは二千億円とまさに大規模投資が要求され、デジタル家電用半導体集積回路生産にはまったく整合しません。一台の装置が複数の異なるプロセスを連続して行えると、シリコンウェーハ月産千枚二千枚といった少量生産でもすべての装置がフル稼働になり十分な利益を得ることができます。
一括投資型からこうした段階投資型の産業に半導体産業を転換させるべく、我々の研究室では異なる複数プロセスが連続して処理可能なマイクロ波励起超低電子温度高密度プラズマ装置の開発・実用化に全力を注いでいます。
異なる複数プロセスを連続して処理する装置を具現化するには、異なる複数種類の原料ガスを順次高速に切り替えて装置に供給するガス供給系が必要になります。一枚一枚シリコンウェーハを処理する枚葉業方式の製造装置におけるプロセスの開始、停止は通常エンドポイントのバルブの開閉で制御されます。複数の異なるプロセスを次から次へと同一の製造装置で行おうとすると、異なるプロセスごとに必要な異なる複数のガスを設定されたタイミングで設定された濃度でシリコンウェーハ表面に供給する必要があります。
完全な再現性のあるプロセスを行うには基板表面に供給される複数のガス種が狙い済ましたタイミングで設定された濃度に誤動作無く供給されなければなりません。自動弁とも言われる空圧弁は、気密性の高い構造を有しており、流体圧力が1MPa以下であれば容易に制御できるという特徴があります。しかしながら、空圧弁は、駆動部への気体の充填・放出に要する時間が応答時間の9割程度を占めるため、バルブの開閉動作が数十msecと遅く、かつ、気体を供給する計装チューブの長さ、あるいは供給する気体の圧力によってバルブの応答時間が異なるという問題があります。その結果、バルブの操作順序とそれらバルブの実動作順序にズレが生じるため、逆流が生じる、基板表面での初期ガス組成·圧力に揺らぎが生じるという不具合がありました。
(株)フジキンと共同で開発したECV®は、弁座おさえ及び上下動させると共に、バネの力も利用することによって、弁座と弁座おさえとの間を開閉するため、空圧弁における駆動部への気体の充填・放出という動作時間を省くことができ、バルブ開閉に要する時間が数msec台という大きな応答速度を有するという特徴があります。また飽和磁束密度が2T(テスラ)以上の鉄・コバルト系合金または鉄・ニッケル系合金からなる磁性体材料を開発したことにより、磁性体材料の体積を非常に小さくすることが可能となったため、流休制御バルブの小型化及び小径化を図ることもできました。
コイルヘ供給する励磁電流を、開弁までの大きな初期駆動電流と、開弁後に開弁状態を保持するための小さな保持電流とに分けて供給することによって、上述したコイルの発生する磁界によって、磁性体をコイル方向に高速度で引きつける動作を行う駆動部における消費電力も小さな値に抑制しています。本ECV®と同時期に開発したガス圧力制御による流量制御方式のフローコントローラとの組み合わせにより、エンドポイントのECV®の開閉のみで、プロセス開始時から装置内基板上の原料ガス組成・圧力を高精度に制御可能となったのです。
ECV®は、操作する人間の個人差や計装用チューブ長や気体圧により応答時間のズレを生じず逆流などの心配もまったく無くなりました。また電気信号による高速で、かつ一定の開閉操作が行え、しかも小型で信頼性の高いガス供給システムが可能となったのです。
さらに、これまでの超LSIの機能発現部は、いずれも単結晶材料あるいはアモルファス材料により構成されていました。しかしさらなる機能並びに性能向上を狙って、強誘電体薄膜や高誘電率薄膜のような多結晶材料を機能発現部に導入する時期がシリコン技術に訪れています。強誘電膜、高誘電率膜は、通常3元素あるいは4元素の酸素化合物であり、可能な限り薄い膜厚で十分な強誘電性、高誘電率性を発揮させようとすると、成膜の一原子層目から完全に元素組成が制御された成膜技術が必須となってきます。現状の空気圧によりバルブの開閉を行っていたのではこのような多結晶材料を一原子層目から完全な組成で成膜することはまったく不可能です。
フィードフォワード制御方式による成膜一原子層目から元素組成を完全に制御するプロセスがこのECV®を使用することで可能になったのです。
私たちの研究施設では、製造装置のガス供給パネルは全面的にECV®を採用しています。外部リークのまったくない溶接継手、高信頼性溶接技術、金属内表面不働態処理技術を組み合わせることにより、必要なときにエンドポイントのバルブを開閉するだけで、高純度のガスを狙い済ましてプロセスチャンバ内基板表面に供給可能となりました。このECV®は半導体製造及び平板デジタルデイスプレイの生産プラントにすでに全面導入されており、生産ラインの信頼性・稼働率・生産性向上に大きく貢献しております。
新しい時代を迎えようとしている半導体・大型デイスプレイ産業の中で、本ECV®の重要性はますます大きくなるものと確信し、本技術を第2回モノづくり部品大賞に推薦致します。
2005年1月20日
1. 部品の内容および特徴
当電動小型ダイレクトダイヤフラムバルブ(以下「ECV®」と呼ぶ)は主に半導体製造装置の特殊材料ガスを供給するバルブとして使用されます。一般的に上記のバルプはクリーンスペック仕様のため空気圧用の電磁弁とはバルブ閉止のための出力が異なり、非常に大きくなります。
クリーンスペック用バルブのアクチュエータは発生する推力の優位性からエアー作動式が主に使用され、小型のクリーンスペックの電動弁はなかなか市場に現れませんでしたが、特殊合金を使用したソレノイドを採用することにより大きな推力を得て、エアー作動並みの小型の電動弁を開発しました。その特徴は、バルブの作動を電動で行い高速応答を可能にすることです。一般的な従来のエアー作動タイプのバルブと比較して、作動遅れの少ない高速開閉が可能となるもので、その主な特徴は
- 1. バルブの応答時間が従来のエアー作動バルブの約1/10とした。(応答時間5msec以下)
- 2. 特殊材質の強力ソレノイドを使用して、 アクチュエータをエアー作動バルブと同様の大きさにした。
- 3. バルブの駆動は電気のみで可能とした。
- 4. クリーンスペックのダイレクトダイヤフラム構造で、1000万回の高耐久性を実現した。
ECV®の仕様
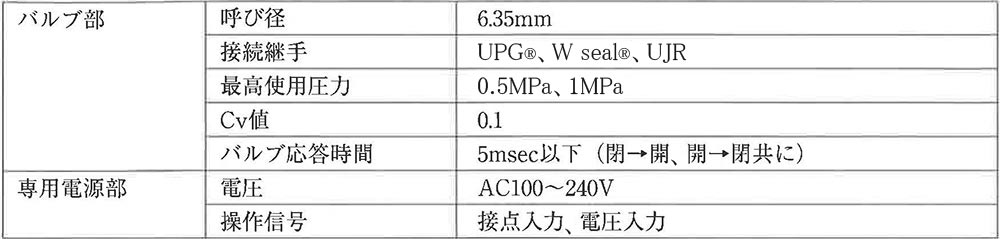
ECV®の構成
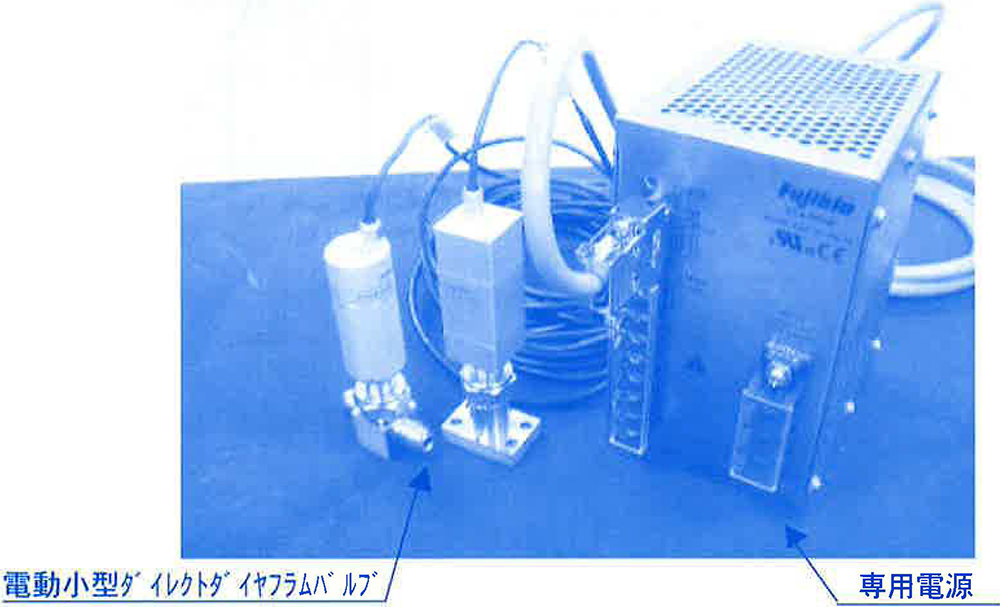

半導体製造装置は半導体製造過程で各種のガス(腐食性ガス、毒ガス等)を使用し成膜したり、エッチングを行ったりして半導体を製造します。
そのガスを供給する設備をガス供給系と呼びますが、そのガス供給系内にはガスを流したり止めたりするクリーンスペックのダイレクトダイヤフラムバルブが使用されます。
現状一般的に使用されているエアー作動タイプのバルブでは、操作圧力や操作圧力供給用チューブの影響によりバルブの応答時間が変動してしまいます。
上記応答時間の変動により
- ① バルブ作動タイミングのズレによるガスの切り替え不良
- ② 流量のオーバーシュート
- ③ プロセスチャンバヘのガスの到達時間の見積り間違い等の問題点が発生することがあります。特に最近の半導体製造プロセスに於いて主流となりつつあるALD(原子層蒸着法)プロセスでは、バルブを高速開閉で使用することが多くなってきています。ECV®はこれらの要求を充分に満足するバルブとなっています。
2. 経済効率
(1)技術の独創性
① バルブ部
・電動バルブにて、従来のエアー作動バルブのアクチュエータ径と同等とするために、飽和磁束密度が2ステラ以上の特殊合金を採用したソレノイドを使用しております。
・ソレノイドをアクチュエータに採用する事により、従来のエアー作動バルブでは作動時の抵抗となっていたOリングを極力少なくすことにより、バルブ応答時間5msec以下を達成。
ECV®アクチュエータ断面略図

② 専用電源部
・ソレノイド吸着時に最も大きな力が必要になりますが、その力を得るために操作信号入力後5msecだけ大電流を流して強力な推力を発生させています。
・ソレノイド吸着後は吸着維持のための電流値が小さくて済みますので、消費電力の低減とソレノイドの発熱防止のため電流値を小さくしております。
専用電源の電流制御グラフ
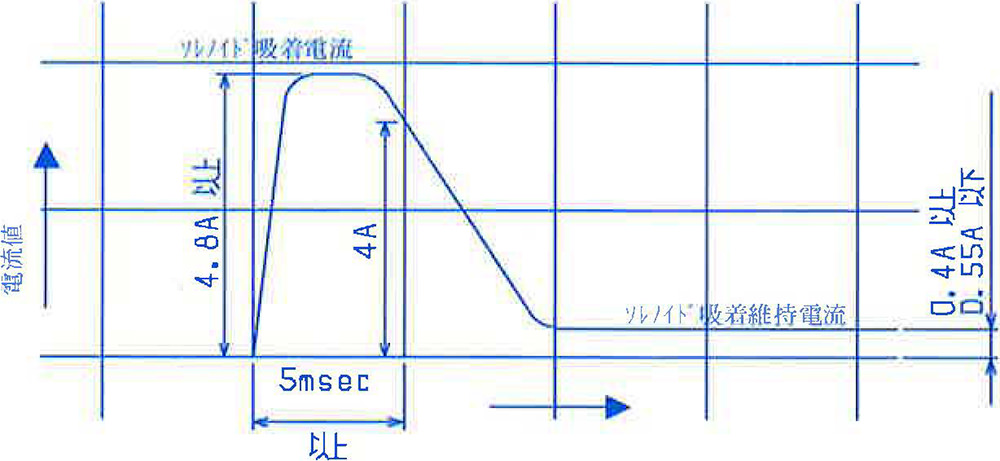
(2)性能
バルブの応答時間
バルブの応答時間の測定系を次頁図に示します。バルブの作動確認にはバルブボディを切断して金属ダイヤフラムの動きを直接レーザー変位計で測定します。バルブの操作信号は、専用電源に入力する操作信号をオシロスコープでモニターします。
バルブ対応時間測定装置略図

現在最も一般的に使用されていますバルブ操作圧力制御に3方電磁弁を用いたエアー作動バルブ(常時閉型)の場合、閉状態から開に作動させる時、電磁弁が作動して操作圧力がバルブのシリンダーに充墳され、ピストンが動き始めるまでのオフバランスと呼ばれる作動遅れ時間があります。上記作動遅れがあるため工アー作動バルブでは50~60msecの応答時間になります。また、同時に複数台数バルブを作動させた場合の遅れや、チューブ長さの違いによる応答時間のバラツキが発生してしまいます。
ECV®の場合は、上記の測定結果の様にソレノイドによる直接駆動であるため、一般的なエアー作動バルブの応答時間の約1/10である5msec以下の応答時間でバルプが開閉します。
(3)経済性
当ECV®を使用することにより電気で直接バルブを作動することが出来るため、従来のエアー作動バルブを使用したシステムで必要だった、三方切り替え電磁弁,エアーチューブ配管,作動用圧力源(コンプレッサー等)が必要なくなるため、ガス供給システムの簡素化とコストダウンにより、経済性は改善されます。また、作動時には大電流が必要ですが、作動保持の時は電流値を小さくして消費電力を抑えています。

(4)実績と今後の普及見通し
2004年1月~2004年12月までの出荷実績はバルブ604ヘッド,専用電源60セットとなっています。今後、半導体産業は微細化が益々進み高度なプロセスが必要になって来ますので、高性能のバルブの用途は益々増えてくると予測されます。
(5)安全性および環境への配慮
4チャンネル用専用電源のCEマーク宣言,米国UL規格の取得により、安全性を考慮しております。
3. 特許関係件数
(1)名称:流体制御バルブ及び流体供給·排気システム
出願番号:特願平10-525441
(2)名称:ソレノイド駆動式金属ダイヤフラム型開閉制御弁
出願番号:特願平11-047831